3D-ICがモバイルPCにやってきた

半導体ICチップを重ねて、貫通電極(TSV)でチップ間をつなぐという3次元ICが、これまでのハイエンドサーバーやHPC(スーパーコンピュータやハイエンドの高性能コンピュータ)から、パソコンレベルに降りてきた。インテル社がクアッドコアのCPUである第8世代Coreプロセッサと、AMDのグラフィックスICチップRadeon RX Vega Mシリーズ、3次元DRAMであるHBM 2(高速バンド幅メモリ)を、インテルのEMIB(埋め込みマルチチップ配線ブリッジ)と呼ぶシリコン内蔵基板に搭載したプロセッサボードをモバイルPC向けに発売したのだ。
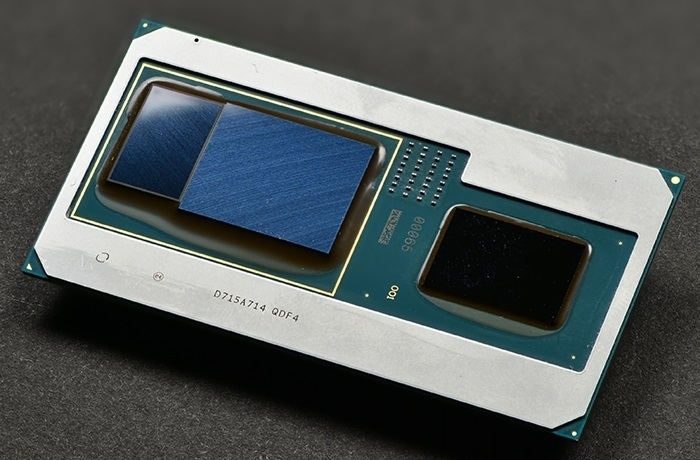
図1 Intelの第8世代COREプロセッサとAMDのGPU、超高速DRAMメモリのHBMを1枚のプロセッサボードに集積した 出典:Intel
このニュースは、海外ではIntelがこれまでのライバルだったAMDと手を組んだ、という視点で採り上げられているが、今回のコラボではAMDのCPUではなく、GPU(グラフィックスチップ)をIntelが採用することになったもので、AMDのIntel互換CPUを使う訳ではない。もともとAMDが持っているGPUは、かつてカナダのグラフィックスチップメーカーのATIを2006年に買収したもので、厳密にいえばAMDが開発したものではない。NIH(Not Invented Here)だ。とはいえ、AMDとIntelがコラボしたという構図はこれまでなかっただけに、海外の視点も面白い。
ただ、これまでTSV技術を使った3D-ICは、コスト的に安くできずハイエンド市場で使われるのがせいぜいだろうとみられていた。経産省が音頭を取り、3D-IC技術をドリームチッププロジェクトとして大々的に組織化したのは2009年。ASET(超先端電子技術開発機構)と名付けられた開発の主力団体は、2013年度までの5年間で3D-ICのTSVを作製することに注力してきた。
しかし、国内の半導体メーカーからも後工程メーカーからもビジネスにつながらなかった。シリコン基板ウェーハを薄く削り、貫通させるTSV技術は工作時間が長くかかり、低コスト化にまで至らなかった。元々日本の国家プロジェクトでは低コスト技術には見向きもせず、ひたすら微細化を追求し失敗してきた歴史があったが、このASETプロジェクトでもビジネスにするための低コスト技術については全く議論されずに終わった。それもプロジェクト期間が終われば、実用化まで継続される議論がなく、プロジェクトは文字通り終わり、さよならを迎えただけだった。
米国や欧州では、チップを積層しTSVで配線電極をつなぐ3D-ICはDRAMで検討された。HBM(High Bandwidth Memory)やHMC(Hybrid Memory Cube)と呼ばれ、DRAMの高速化に向けた3D-IC構造に変えたのである。市販のDRAMをただ単に重ねただけの構造ではない。市販のDRAMでは、チップ上のメモリマトリクスにあるメモリセルを長辺側と短辺側からアクセスし、どちらかからメモリセルのデータを読み出していた。しかしHBMでは、TSVを通して縦方向にデータを読み出している。すなわち、最下層のチップは読み出すためのセンスアンプを備えたアクセス回路になっている。その上に重ねたチップはDRAMアレイであり、それらには読み出し/アクセス回路が載っていない。
海外勢が韓国のSK HynixやSamsung、米e-Silicon、台湾ASE、米Rambus、米Northwest Logicなどとエコシステムを作り、それぞれ得意な技術を持ち寄り、HBMを商用化させると共に、データセンターやAI学習向けなどに提供し始めているのだ。SK HynixはDRAMメモリそのもの、Samsung はメモリをよく知るファウンドリ、e-Siliconはアーキテクチャ、ASEは実装・パッケージング技術、Rambusは高速SerDes(直並列変換チップ)技術、IPベンダーのNorthwestはHBMのコントローラという具合に、技術を持ち寄った。そして、その顧客が今回のIntelであった。
Intelは1枚の回路基板上に、3D-ICであるHBM 2メモリと自社のクアッドコアCoreプロセッサ、そしてAMDのGPUを搭載し、GPUとHBM、CPUとGPUなどの接続には、多層配線を施した小さなインターポーザチップを基板に埋め込むEMIB(Embedded Multi-die Interconnect Bridge)技術を活用した。EMIBはIntelが開発した技術で、チップ同士をつなぐ再配線チップに小さなシリコンチップを用いたため、コスト的には有利な技術となった。
これまでIntelはFPGAとHBMを並べる2.5D技術もリリースしており、クラウドとしてのデータセンターでの高速プロセッサ技術やAIディープラーニング技術も揃えている。今回はデータセンターなどで実績を積み、技術を習熟させ、低コスト技術を磨き、モバイルパソコンに使う半導体ボードとなった。日本のASETが日本だけにこだわらず、海外企業を含めたエコシステムでHBMなり、高密度実装技術をドリームチップとして続けていれば、勝ち組にとどまれたかもしれなかった。
(2018/01/14)










